
行业风口:先进封装成算力竞争关键,国产替代空间广阔
先进封装是半导体产业链的 “后道核心”,简单说就是通过 2.5D/3D 堆叠、芯粒(Chiplet)集成等技术,将多颗芯片高效互连,实现性能提升、功耗降低和体积缩小的关键工艺。在摩尔定律逼近物理极限的背景下,先进封装已从 “辅助环节” 升级为决定芯片性能的核心变量,尤其成为 AI 算力、汽车电子、高端存储等领域的刚需技术。当前行业正处于三大核心红利叠加期,成长确定性极强。
1. 需求端:AI + 汽车双轮驱动,市场规模持续扩容
AI 算力爆发是先进封装需求的核心引擎。普通服务器对封装的需求仅满足基础互连即可,而 AI 服务器因搭载多颗 GPU 和高带宽内存(HBM),对封装的带宽、密度要求呈指数级提升 —— 单台 AI 服务器的先进封装需求是普通服务器的 8 倍,英伟达 GB200、AMD MI350 等高端 AI 芯片,必须依赖 CoWoS(晶圆级系统集成封装)等先进技术才能发挥性能。与此同时,汽车电子的智能化升级也带来增量需求:智能驾驶、800V 高压平台使单车半导体封装价值量较传统车型增长 3 倍以上,车规级先进封装需满足 - 40℃至 150℃的宽温域要求,技术壁垒显著。
权威数据显示,2025 年全球先进封装市场规模已达 503.8 亿美元,预计 2032 年将增至 798.5 亿美元,年复合增长率 6.8%。其中,AI 相关先进封装需求增速最快,仅 CoWoS 市场规模就有望从 2025 年的百亿美元级,跃升至 2027 年的 300 亿美元以上,成为行业增长的核心动力。
2. 供给端:海外产能告急,国产承接溢出订单
全球先进封装产能长期被台积电、日月光等海外巨头主导,但当前已无法满足爆发式需求。台积电的 CoWoS 产能利用率持续维持 100%,订单排期已至 2026 年下半年,英伟达、博通等国际大客户的部分订单开始向国内企业溢出。为缓解供需缺口,台积电计划 2026 年将 CoWoS 月产能提升至 12.5 万片,较 2025 年增长 25%,但即便如此,行业供需缺口仍将持续至 2027 年。
这一背景为国产企业创造了绝佳的替代窗口。国内先进封装国产化率已从 2023 年的 15% 快速提升至 2025 年的 28%,长电科技、通富微电等龙头企业的技术水平已接近国际一流,能够承接中高端封装订单。随着国内企业产能持续扩张,国产替代率有望在 2027 年突破 40%,替代空间极为广阔。
3. 政策端:国家 + 地方双重加持,资金支持力度空前
先进封装作为半导体产业 “卡脖子” 环节,已被纳入国家重点发展战略。国家集成电路产业投资基金(大基金)三期 3440 亿元资金中,30% 专门投向先进封装及配套领域,重点支持 Chiplet、CoWoS 等核心技术研发和产能建设。工信部即将发布《先进封装产业三年行动计划 (2025-2027)》,对 2.5D/3D 封装设备给予 20% 的采购补贴,通富微电苏州基地已入选首批示范名单。
地方层面同样动作频频:上海、江苏、安徽等地形成先进封装产业集群,为企业提供用地优惠、研发补贴等支持;苏州工业园区设立 50 亿元先进封装专项基金,对引进的高端设备给予最高 5000 万元补贴。“国家引导 + 地方落实 + 资本倾斜” 的全方位政策体系,为国产先进封装产业的崛起提供了坚实保障。
龙头解析:6 只核心标的,覆盖全产业链关键环节
A 股先进封装产业链已形成 “封装制造 + 设备 + 材料” 的完整布局,以下 6 只龙头企业凭借技术壁垒、客户资源或产能优势,成为细分领域的核心力量,充分受益于行业景气度提升。
1. 长电科技(600584):国产封测龙头,技术产能双领先
长电科技是中国大陆规模最大、技术最先进的封测企业,全球市场份额排名第三,国内市占率高达 36.94%,稳居行业第一。公司在先进封装领域布局深厚,自主研发的 XDFOI® Chiplet 高密度异构集成工艺已稳定量产,该技术像 “搭积木” 一样将不同功能的芯片裸片集成在一起,性能对标国际一流水平,良率达到 98% 以上,适配 AI、高性能计算、汽车电子等高端领域。
客户资源方面,公司深度绑定英伟达、华为、高通等全球芯片巨头,覆盖 3nm 至 28nm 全制程封装需求,海外营收占比近 80%,通过墨西哥、越南工厂成功规避关税壁垒。产能布局上,2025 年公司投入 85 亿元用于先进产能扩张,上海临港车规级封装基地已通线,形成规模化自动化产能;同时加速长电微电子晶圆级高端制造项目上量,中期目标是将运算类电子业务收入占比提升至 50% 以上。
2. 通富微电(002156):AI GPU 封装核心,绑定全球算力巨头
通富微电是全球高端算力芯片封装的核心供应商,国内市占率 26.42%,位列第二,在 AI GPU 封装领域具备不可替代的竞争优势。公司技术储备全面,Chiplet 2D+、大尺寸 FCBGA、CoWoS-like 等先进技术已全面量产,单封装面积可达 110×110mm²,成功攻克 3nm 制程封装的翘曲与散热难题,技术水平与台积电差距持续缩小。
客户绑定方面,公司与 AMD 形成深度合作关系,承接其 80% 以上的 CPU/GPU 封测订单,即将量产的 AMD MI400 系列 AI GPU 将为公司带来巨额增量收入;同时与英伟达、苹果、特斯拉等企业达成合作,覆盖 AI、消费电子、汽车电子等多领域。产能扩张上,公司 2025-2026 年计划资本开支 60 亿元,苏州、槟城基地扩产后,月产能折合 6 万片 12 寸晶圆,将充分承接大客户增量需求。2026 年 1 月,公司发布 44 亿元定增计划,用于存储芯片封测、高性能计算封测等项目,进一步强化核心竞争力。
3. 华海清科(688120):封装设备龙头,绑定国产扩产核心
华海清科是国产半导体封装设备的领军企业,专注于化学机械抛光(CMP)设备,产品已打破海外垄断,成为长江存储、长鑫存储等国产巨头的核心供应商。公司的 12 英寸 CMP 设备已批量导入长鑫存储 DRAM 产线,覆盖 DDR5 制造关键环节,2025 年相关订单金额 3.2 亿元,同比增长 52%;14nm 以下先进制程抛光设备通过验证,成功进入长江存储 294 层 NAND 供应链,存储业务占比超 58%。
在先进封装配套设备领域,公司的 Versatile-GP300 减薄抛光一体机集成磨削减薄、化学机械抛光与清洗模块,攻克复杂翘曲晶圆传输难题,性能对标国际一线产品;Versatile-GM300 减薄贴膜一体机兼容 W2W 和 D2W 两种先进封装工艺路线,获得头部封测企业批量订单。随着国产存储、封测企业持续扩产,公司设备需求将持续高增,2026 年订单有望实现翻倍增长。
4. 安集科技(688019):封装材料标杆,打破进口依赖
安集科技是国内半导体材料领域的标杆企业,在封装用化学机械抛光液、电镀液等核心材料领域实现重大突破,打破了海外企业的长期垄断。公司的封装抛光液产品已通过长电科技、通富微电等龙头企业的验证,批量应用于 2.5D/3D 封装、Chiplet 等先进工艺,产品性能达到国际先进水平,价格较进口产品低 15%-20%,具备显著的性价比优势。
受益于先进封装产业的快速发展,公司封装材料业务收入持续高增,2025 年相关产品销量同比增长 45%,在国内市场的市占率已提升至 22%。公司还积极布局封装用金属薄膜材料、光刻胶配套材料等新品,形成多元化产品矩阵。作为大基金三期重点扶持企业,公司获得专项资金支持用于先进封装材料研发,技术迭代速度持续加快,与国际巨头的差距不断缩小。
5. 晶方科技(603005):TSV 技术龙头,深耕细分高增长赛道
晶方科技在 TSV(硅通孔)封装技术领域具备全球竞争力,该技术是先进封装的核心工艺之一,通过在硅片上打孔实现芯片的垂直互连,广泛应用于传感器、存储器等产品。公司的 TSV 封装技术国内领先,良率长期保持在 97% 以上,全球每两颗手机摄像头 CIS 芯片就有一颗采用其封装技术,市场份额稳居全球前列。
在汽车电子领域,公司的车载 CIS 封装产品已进入特斯拉、比亚迪等主流车企供应链,受益于自动驾驶摄像头数量增加的趋势 —— 单台智能汽车的摄像头数量已从传统车型的 2-3 颗增至 8-12 颗,直接拉动车载 CIS 封装需求增长。此外,公司积极拓展 AIoT、医疗影像等领域,TSV 封装产品在智能穿戴设备、医疗传感器等场景的应用持续落地,形成 “消费电子 + 汽车电子 + AIoT” 多驱动格局。
6. 大港股份(002077):先进封装后起之秀,产能扩张提速
大港股份通过收购苏州科阳切入先进封装领域,聚焦 WLCSP(晶圆级芯片尺寸封装)和 Chiplet 技术,是国内为数不多具备规模化先进封装产能的企业之一。公司的 WLCSP 封装产品具有小型化、高集成度的优势,广泛应用于智能手机、平板电脑、物联网设备等终端,客户包括国内主流芯片设计企业和消费电子厂商。
产能布局方面,公司苏州基地已形成年封装 12 亿颗芯片的产能,2025 年新增投资 15 亿元用于先进封装产能升级,重点扩大 Chiplet 和车规级封装产能,预计 2026 年产能将提升至 18 亿颗 / 年。技术研发上,公司与国内高校、科研机构合作,持续加大 Chiplet 技术投入,已实现 2-4 颗芯片集成的 Chiplet 封装量产,良率达到 95% 以上,成功切入中高端市场。随着产能释放和技术升级,公司有望在国产替代浪潮中实现快速成长。
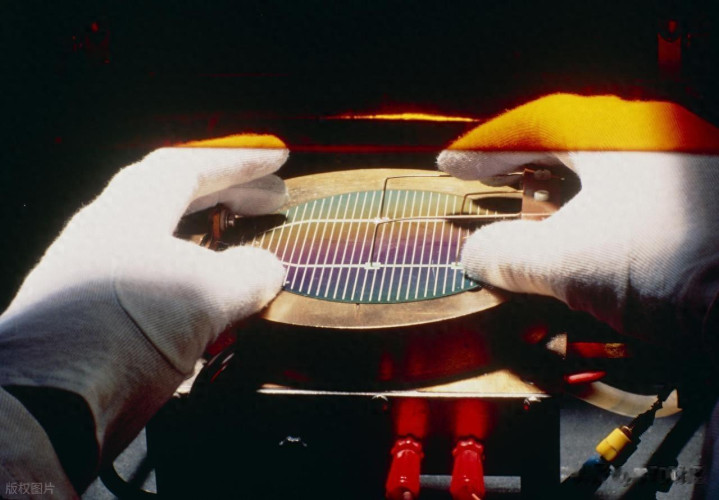
熊猫配资提示:文章来自网络,不代表本站观点。